
電子構裝製造技術
IC晶片必須依照設計與外界之電路連接,才可正常發揮應有之功能。用於封裝之材料主要可分為塑膠(plasTIc)及陶瓷(ceramic)兩種。其中塑膠構裝因成本低廉,適合大量生產且能夠滿足表面黏著技術之需求,目前以成為最主要的IC封裝方式。而陶瓷構裝之發展已有三十多年歷史,亦為早期主要之構裝方式。由於陶瓷構裝成本高,組裝不易自動化,且在塑膠構裝品質及技術不斷提昇之情形下,大部份業者皆已盡量避免使用陶瓷構裝。然而,陶瓷構裝具有塑膠構裝無法比擬之極佳散熱能力、可靠度及氣密性,並可提供高輸出/入接腳數,因此要求高功率及高可靠度之產品,如CPU、航太、軍事等產品仍有使用陶瓷構裝之必要性。
目前用於構裝之技術,大概有以下數種。分別為「打線接合」、「捲帶式自動接合」、「覆晶接合」等技術,分述如下:
打線接合(Wire Bonding)
打線接合是最早亦為目前應用最廣的技術,此技術首 先將晶片固定於導線架上,再以細金屬線將晶片上的電路和導線架上的引腳相連接。而隨著近年來其他技 術的興起,打線接合技術正受到挑戰,其市場佔有比例亦正逐漸減少當中。但由於打線接合技術之簡易性 及便捷性,加上長久以來與之相配合之機具、設備及相關技術皆以十分成熟,因此短期內打線接合技術似 乎仍不大容易為其他技術所淘汰。
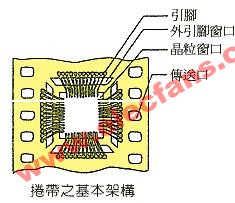 捲帶式自動接合(Tape Automated Bonding, TAB)
捲帶式自動接合(Tape Automated Bonding, TAB)
捲帶式自動接合技術首先於1960年代由 通用電子(GE)提出。捲帶式自動接合製程,即是將晶片與在高分子捲帶上的 金屬電路相連接。而高分子捲帶之材料 則以polyimide為主,捲帶上之金屬層則以銅箔使用最多。捲帶式自動接合具有 厚
度薄、接腳間距小且能提供高輸出/入接腳數等優點,十分適用於需要重量輕 、體積小之IC產品上。
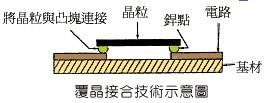 覆晶接合(Flip Chip)
覆晶接合(Flip Chip)
覆晶式接合為IBM於1960年代中首 先開發而成。其技術乃於晶粒之金 屬墊上生成粒銲料凸塊相對應之接點 ,接著將翻轉之晶粒對準基版上之 接點將所有點接合。覆晶接合具有最短連接長度、最佳電器特性、最高輸出/入接點密度,且能縮小IC尺寸,增加單位晶圓產能,已被看好為未來極 具潛力之構裝方式。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)